
�� AI �ֻ��߸��س����£�����Ϸ��Ⱦ������ʽ AI ͼ�����ɵȣ��û��������豸�������졢�������������⣬����ԭ������ AI оƬ������������Ĺ��ļ�������ǰ�콢���ֻ� AI оƬ�ķ�ֵ������ͻ�� 15W�����ֻ��ڲ����յĿռ䣨�������ͨ������ 100cm²�������������Կ�����ɢ����������һϵ�����⣺һ���棬���»ᵼ��оƬ��̬��Ƶ����Լ AI �����ͷš���һ���棬���ڸ��»���ٵ���Ԫ�����ϻ����ݡ�ӡ�Ƶ�·�� PCB ����ơ�����־ΰ�ȱ��������ݣ�����Ԫ�����¶�ÿ���� 2�棬�ɿ��Խ��� 10%������ 50��ʱ��������Ϊ���� 25��ʱ�� 1/6��
�����ѵ���������ӭ�������ں����������������˳���AI�ն˵ı���������AIPC�Լ�AI�ֻ�ʵ�ֱ��ظ�Ч����֧�֣������۾�ʵʱ���룬AR������ʵ�ù��ܵ�����
���г����ƿ���AI �ֻ����ռ���һ���Ŵ���ɢ������IDC Ԥ�⣬2025 ��ȫ���������ʽ AI ���ܵ������ֻ����������� 3.7 �ڲ���ռ�����г��ݶ� 30%��OCID ������ʾ��2027 ���й��˹������ֻ�����Ԥ��ͻ�� 1.86 ��̨���Ӵ�ij���������ɢ�ȼ����ѳ�Ϊ����ʵ�ֲ�Ʒ���컯�Ĺؼ�ָ�꣬ͬʱ��ƽ�������߶��豸�ᱡ��������
01��ͳ�ֻ�ɢ��
�����ֻ�ɢ���Թ��嵼��Ϊ�������IJ���Ϊͭ��ɢ�Ȱ壨ͭ�ĵ���ϵ��Լ 401W/(m・K)����ͨ��ֱ������оƬ��Դ�����������������������ɢ��Ƭ����Ϊ���ƣ�����ϵ�� 237W/(m・K)��������ɢ���÷������������ڽṹ���ɱ��ɿأ����������Լ���ƿ���� ����ȫ����߹���AIоƬ��ɢ������ Ϊ����ɢ��Ч�ʣ�������ɢ�Ȱ� / Ƭ�ı�������ȣ�����ǰ�ֻ��ᱡ�����Ҫ��ɢ��ģ���ȿ����� 1.5mm ���£���ͳ������ɢ�ȹ�������������һ���߹��� AI оƬ��
����Դ������ѧ�������豸�ȹܣ�
02VC ���Ȱ�ļ���ԭ����Ӧ��
Ϊ��� “��ɢ������” �� “�ᱡ��” ��ì�ܣ�VC ���Ȱ壨Vapor Chamber����Ϊ�߶� AI �ֻ�������������VC���Ȱ� ��Ϊһ�ָ�Ч��䴫��װ�ã��乤��ԭ�����ڷ�տռ��ڹ��ʵ�����-����ѭ�������ȹ����ƣ�VC���Ȱ����ù�������ջ����µ�������ʵ�ָ�Ч�������ݣ�����ƽ��ṹ���ʹ����и����ɢ����������ȵ��¶ȷֲ���
VC���Ȱ�Ļ����ṹ������
��ǣ�ͨ��������ͭ(C1100/C1020)���ʣ��������õĵ������ܺͿɼӹ�
ëϸ�ṹ�����ͭ��+������ƣ��ṩ���ʻ�����ëϸ��
���ʣ�ȥ����ˮ�ȵͷе�Һ�壬����ջ����µ��¼�������
֧������ͭ��������ֹ���ǻ�ڴ���ѹ�±��Σ�ͬʱ��ǿ�ṹǿ��
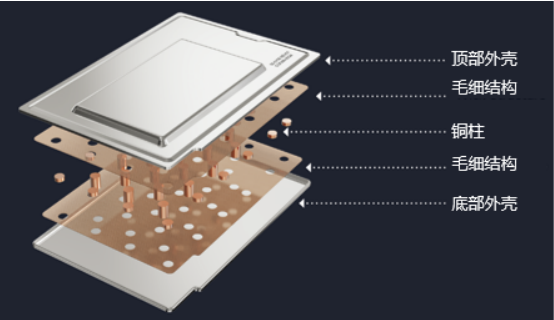
���������У�VC���Ȱ���ȶ�����������ʹ����������������������ѹ��������Ѹ����ɢ����ˣ��ͷ�������������Һ�壻Һ��ͨ��ëϸ�ṹ��ëϸ���������ȶˣ����һ���������ȴ���ѭ������һ���̵� ����ϵ���ɴ�10000-50000W/mK����ͭ��25-125����������50-250����չ�ֳ�Խ��ɢ������ ��
����Դ��iPhone 17 Pro“���Ѵ���”��ɢ�ȸ��������VC���ȹ�����2025-09-18��
ɢ�ȹ��̻�����䴫�ȣ������������£�
01 ������
оƬ��Դ������ǻ��ײ���ëϸо�еĹ��������������������մ���������
02 ��ɢ��
ˮ������ǻ���ڲ�ѹ���������£�������ɢ����������ͨ��Ϊǻ�嶥�������ϻ���ɢ������
03 �����
ˮ��������±���Ӵ����ͷ�����������ΪҺ̬��
04 ������
Һ̬ˮͨ��ëϸо��ëϸ�����ã���������Դ�������ѭ����
��һ���̵ĵ���ϵ���ɴ�10000-50000W/mK����ͭ��25-125����������50-250����չ�ֳ�Խ��ɢ�����ܡ�
����Դ��iPhone 17 Pro“���Ѵ���”��ɢ�ȸ��������VC���ȹ�����2025-09-18��
03VC ���Ȱ��ᱡ���ļ�����ս
��ǰ�ֻ����̶Ի�����ȵ����ֻ����ѵ��� 7.5mm����Ҫ�� VC ���Ȱ��Ƚ�һ��ѹ���� 0.3mm ���£��ɴ˴���������ļ������⣺
01 �ܷ����������ì��
ǻ���ȼ�С�����ڲ�������������㣨��≥0.1mm ���ܱ�֤ˮ����˳����������ͬʱ�ܷ���Ѷ��������� —— ���ü��⺸��ʱ���������������� 0.2mm ���ڣ�������⺸��Ӧ������ǻ����Σ�������ƻ���ջ���������ɢ��ʧЧ��
02 ��䴫������˥��
��ǻ���ȵ��� 0.4mm ʱ��ëϸо����Ч��Ȳ��㣨��≥0.15mm ���ܱ�֤�㹻��ëϸ����������Һ̬ˮ�����ٶ��½���ͬʱˮ������ɢ·�����̣��׳��� “��Һ���” ����ʹ��Ч����ϵ���衣
Ŀǰ��ҵ����ͨ�����ּ���·��ͻ��ƿ����һ�Dz�������ëϸо���ϣ��������ͭ����϶�������� 70%������ǿëϸ������������Ч�ʣ������Ż�ǻ��ṹ������ý���ʽ�������ֲ������� 0.5mm�����ڱ�֤�����ᱡ��ͬʱԤ���㹻�����ռ䡣δ��������Щ�����ij��죬VC ���Ȱ彫���õ�����AI�ֻ���ɢ������
������ս��
��ΪVC���Ȱ�ĺ����ڲ��ṹ��ͭ����ëϸ�ṹ�ijߴ�������ڶ���ì����Ѱ��ƽ���������ͭ����Ҫ��֤�ṹǿ�ȣ�����ߴ����������谭������ɢ������Һ�������������裬����ִ���������ڲ�������ʽͭ������ȷ��������������ͬʱ��С������������ȵĸ��š�ëϸ�ṹ��Һ�����������������ߴ�ֱ��Ӱ�����ܼ��ޣ���������С���ܲ���ǿëϸ�������ᵼ��Һ���������������������������������ʹëϸ�����㣬�������������˸ɺԡ������������Ϊëϸ�ṹѡ����Ѻ�������Χ����������ۺ�����ϵ������ƽ��ëϸ�������ʣ���
����ƺ����������������Ҫ��עͭ����ֱ����߶ȣ�ëϸ�ṹ�ĺ�����������/�İ���ȱ�ݼ����ȷ��VC���Ȱ��������
�۲�VC���Ȱ���Ʒ��

1ͭ��ȱ��
1.1��Ե
8μm���طֱ��ʶ�ROIɨ����ɹ۲쵽ȹ�ߡ�������ͭ����ͭ���ṹ��ע�ͭ����һ�����ݡ�
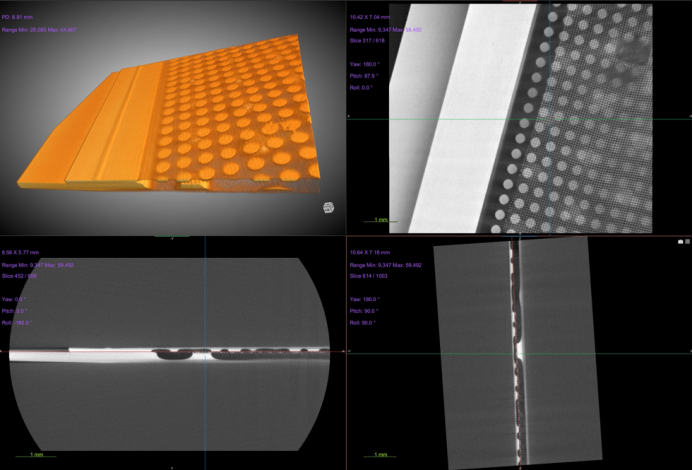
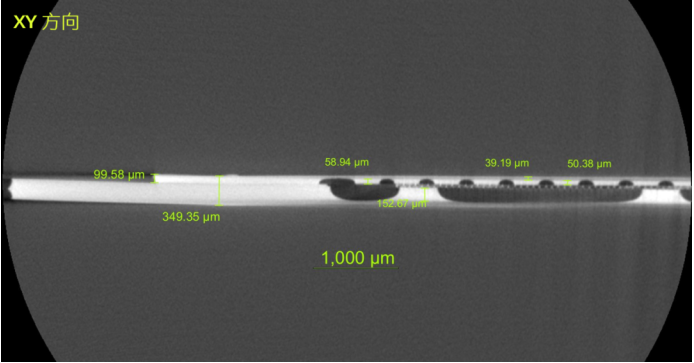
����ȹ�ߺ�ͭ���ȸ���ṹ�ĺ��
ZEISS��3D������ʾ�ع����2D��Ƭ��XY����
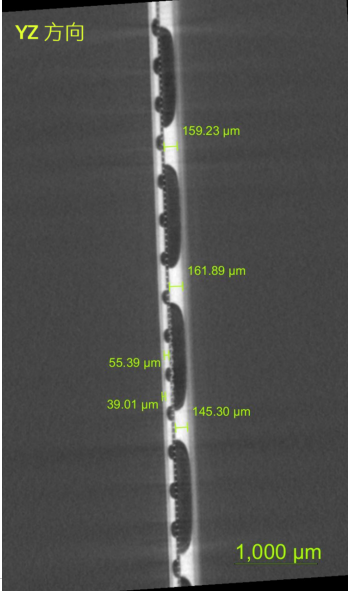
ZEISS��3D������ʾ�ع����2D��Ƭ��YZ����
���أ�8μm
��Ե������ͭ��ֱ��
�����ݴ�ͭ����һ���Ŵ�ɨ��
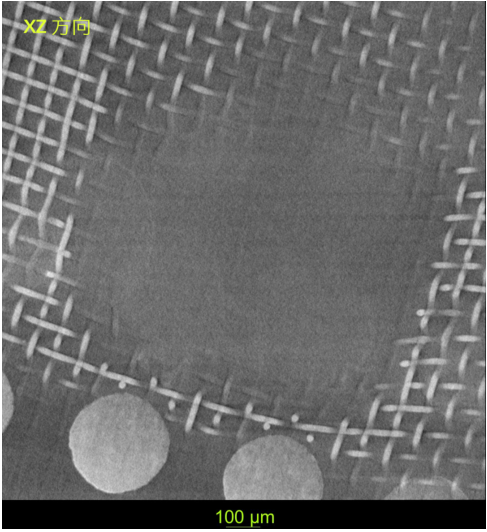
ZEISS��3D������ʾ�ع����2D��Ƭ��XZ����
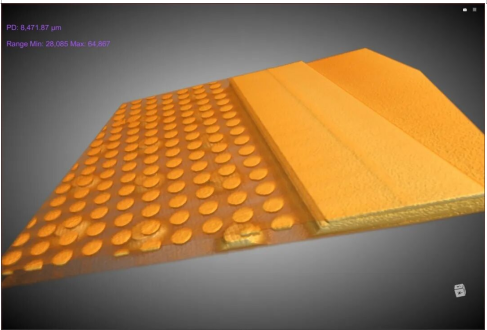
ZEISS��3D������ʾ�ع����3D�ṹ
���أ�8μm
1.2ͭ��ȱ��
1.5μm���طֱ��ʶ��ݴ�ͭ��ɨ����ɹ۲쵽ͭ����ͭ�����Ρ�ճ����

ZEISS��3D������ʾ�ع����2D��Ƭ��
ÿ��������һ����ͬ������������Ƭ����ɫ�߶�Ӧ��ͬ�ı߿���ɫ��Ƭ�����磬���������ڵ���ɫ��λ�ö�Ӧ����������ɫ�߿��ڵ�2D��Ƭ��
ͨ���ƶ���ɫ�߿��Թ۲��Ӧ��ɫ�߿��ڵ�������Ƭ�仯��
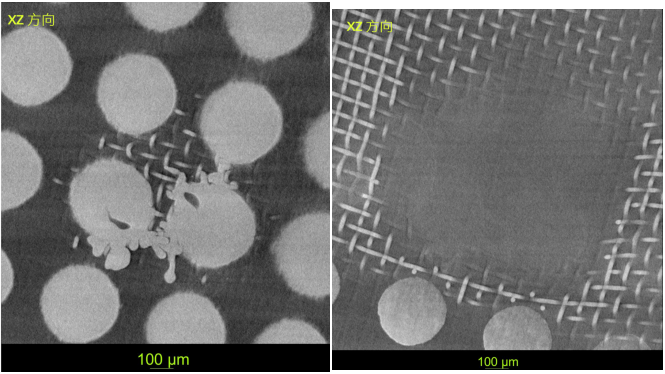
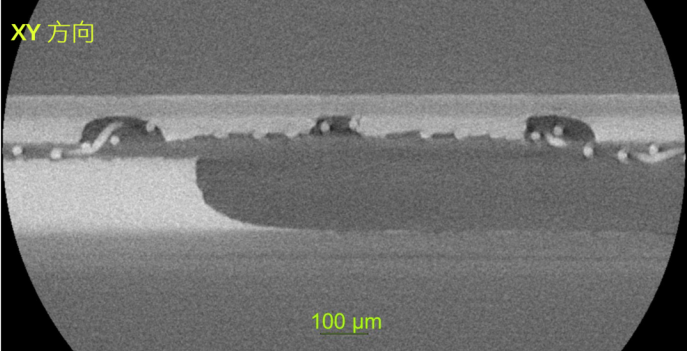
ZEISS��3D������ʾ�ع����2D��Ƭ��XY����

��������ͭ����δ����ͭ���ĺ�ȣ�����ͭ���ڿ�϶��С��ͭ����֯�ṹ�Ŀ���
ZEISS��3D������ʾ�ع����2D��Ƭ��YZ����
���أ�1.5μm
��˾���������
ZEISS Xradia Versa X������������������ά��������ΪVC���Ȱ���ڲ��ṹ������ȱ�ݷ����ṩ�����������������ϵͳƾ����Խ�Ķ�߶ȳ������������ڵͱ�ģʽ�¿��ٶ�λ�ڲ�����ṹ�������л����߱�ģʽ����ëϸ�ṹ��ͭ�������ݵ����������и߷ֱ�����ά���������ר�õ���ά���ӻ�������������û��ɶ���Ʒ��������Ƕȵ�����������������Ⱦ�����ɸ���������ά��ɫģ�ͣ��Ӷ���ȷ��ʾ�ڲ��ṹ�Ŀռ��ϵ��ȱ�ݷֲ���Ϊ��Ʒ�����Ż���ɿ��������ṩ�ؼ��Ķ���������֧�š�
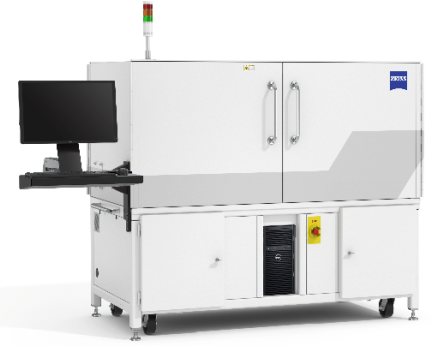
�� ��˾Versaϵ�и߷ֱ�X��������
��˾ӵ�зḻ�IJ�Ʒ�߰�������������ɨ���ǣ������꣬��ҵCT������ȫ�������ӿͻ�����������ս��ʹ�㡣
